(株)東レリサーチセンターと通産省 工業技術院 物質工学工業技術研究所(現 産業技術総合研究所)での研究です。
<1983年~1997年>
透過式小角X線散乱法のソフトウェアの開発と応用この分野の論文リスト
透過法の小角X線散乱(SAXS)の解析に必要なスリット補正(desmearing)やフーリエ変換などのデータ処理と装置制御のプログラムを開発し、SAXS測定・解析システムを築いた。これを用い、炭素繊維、アルミナ繊維、ハードエラスチックポリプロピレンフィルムなどの工業材料の構造解析、例えば、粒径評価、ボイド径評価、長周期の決定を行い、構造と製造条件との関係を議論した。高分子材料に見られるラメラ構造の歪み、すなわち、パラクリスタルの乱れ、結晶サイズの有限性、ラメラの湾曲と小角X線散乱との関係を理論的に明らかにした。その理論の実証として、ポリプロピレンフィルムの散乱像を解析し、電子顕微鏡観察と一致する評価結果を得た。

研究制度
- 科学技術庁 振興調整費「ハイブリッド材料の原子・分子構造の非破壊計測技術に関する研究」 [昭和59~61年度]
反射式小角散乱法の超薄膜材料への応用この分野の論文リスト
積層薄膜材料の精密な構造解析を可能とするためにKratkyカメラを用いた反射型の小角X線散乱光学系を考案し、理学電機の平嶋修氏により製作された(上図)。これに電子計算機を組み合わせ、装置制御および解析用ソフトウェアを開発し、測定・解析システムを築いた。システムの性能をLangmuir-Blodgett (LB)膜や半導体超格子の測定で実証した。 製膜条件の異なる3種のステアリン酸鉛LB膜の小角X線散乱を開発した装置を用いて測定し、ミクロストレインモデル、パラクリスタル理論を用い格子歪み解析を行い、層構造の歪みと製膜条件との相関性を定量的に明らかにした。 さらに、アラキジン酸カドミウムLB膜について、室温から融解に至るまでの昇温過程での構造転移と降温過程での結晶化挙動を解明した。 反射法測定で求めたステアリン酸カドミウムLB膜(21層累積)の小角から広角領域までのX線回折データを求め(中図)、分子鎖の配向を定量的に評価し、フーリエ合成で電子密度分布を求めた(下図)。 すなわち、新たな測定・解析システムを開発し、バルク材料にしか行えなかった精密なキャラクタリゼーションを超薄膜でも可能にした。一連の研究成果を論文としてまとめ、東京工業大学から博士(工学)の学位を取得した。開発した反射型の小角X線散乱装置は理学電機から市販され、国内外の研究機関・企業で利用されている。

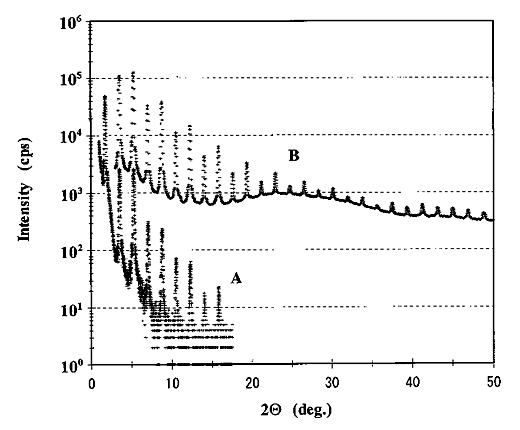

博士論文
- 「反射型小角X 線散乱法による積層薄膜の構造解析」(乙第2332号)、東京工業大学、平成4年、(審査委員 主査:佐々木伸太郎 助教授、副査:安部明廣 教授・野瀬卓平 教授・
渡辺順次 助教授・岡田守 助教授[高分子工学科]・大橋裕二 教授[化学科]、役職は当時)
研究制度
- 科学技術庁 振興調整費「ハイブリッド材料の原子・分子構造の非破壊計測技術に関する研究」 [昭和59~61年度]
二重湾曲 W/Si 多層膜を用いた高輝度点収束小角X線散乱光学系の開発と最大エントロピー法による画像解析この分野の論文リスト
2重湾曲W/Si多層膜モノクロメーターを用い高輝度の小角X線散乱光学系(下の写真)を理学電機の小林勇二氏・佐々木勝成氏と共同で開発し、ポリエチレンフィルム、ラットのコラーゲン等の測定から、本装置が約35nm(最大評価可能面間隔)の分解能と通常光学系の数10~100倍の強度を与えることを示した。多層膜モノクロメーターを用いた高輝度の小角X線散乱光学系と実験室レベルのX線源で液晶転移現象の時分割測定に成功し、最大エントロピー法の画像処理で、僅か3秒の露出で得られたポリエチレンフィルムの散乱データから長周期像を再現し(下図)、実験室レベルの小角X線散乱の時分割測定を可能にした。この光学系はよりコンパクトに改良され、 ナノスケールX線構造評価装置として、理学電機から市販されている。
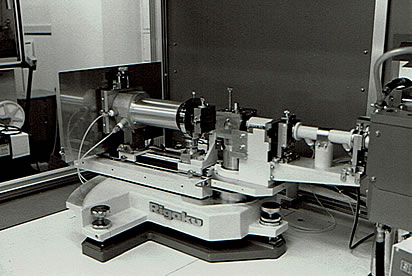

研究制度
- 通産省 工業技術院 物質工学工業技術研究所 重点研究「X線回折用高品位画像解析システムの開発」(研究代表、共同研究:Dr. Robert V. Law) [平成7年度]
